武漢「中國光谷」微信公眾號11日發布的消息,華工科技已成功製造出中國首台核心零組件100%國產化的高端晶圓雷射切割設備,這意味中國在攻克零組件「卡脖子」上再進一步。
晶圓切割機是一種使用機械或雷射等方式切割晶片的高精度設備,屬於半導體封測後段關鍵環節,切割的品質與效率會直接影響晶片的封裝品質和生產成本。
華工激光半導體產品總監黃偉表示,晶圓機械切割的熱影響和崩邊寬度約20微米,傳統激光在十微米左右。經過一年努力,華工科技半導體晶圓切割技術成功實現升級,熱影響降為零,崩邊尺寸降至五微米以內,切割線寬可做到十微米以內。
該公司透露,華工正在研發第三代半導體晶圓雷射改質切割設備,計劃7月推出新產品,同時正開發中國自主知識產權的第三代半導體晶圓雷射退火設備。
據調研機構數據,2022年半導體晶圓切割設備市場約17億美元(中國市場5億美元),其中,2022年前三大廠商DISCO、東京精密和光力科技份額佔比超過87%,DISCO佔有超65%份額,東京精密25%,中國國有化率則為10%。
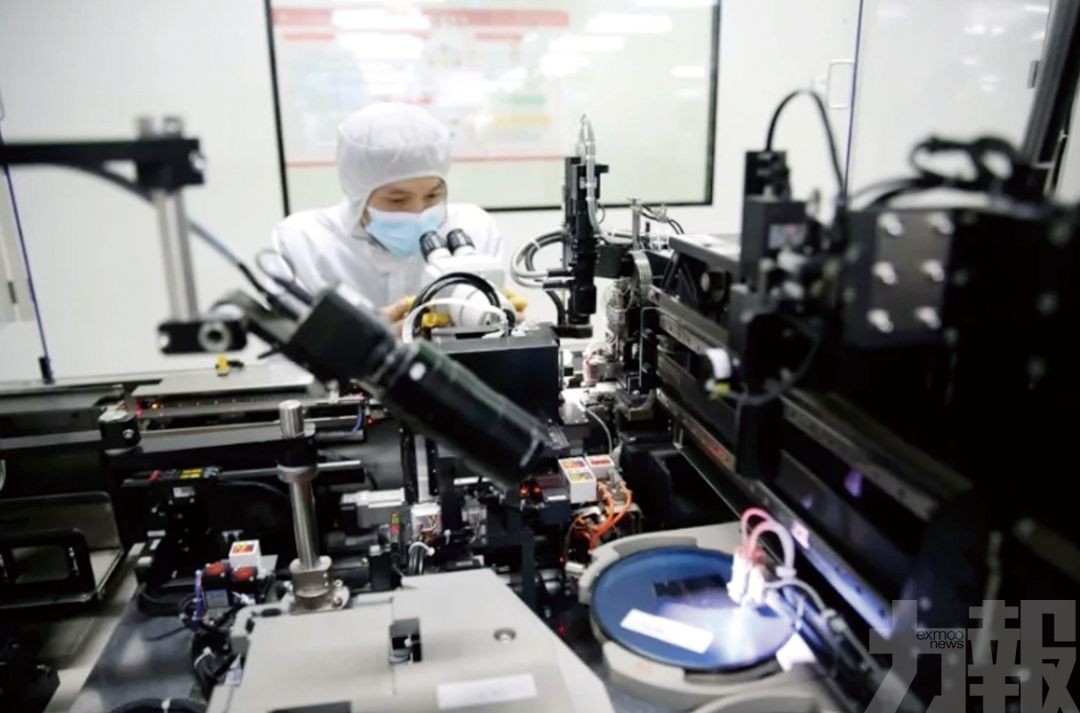
華工科技宣布已成功製造出中國首台核心零組件100%國產化的高端晶圓雷射切割設備。(網絡圖片)









